- Високороздiльний рентгенiвський дифрактометр X'Pert PRO MRD з набором рентгено-оптичних компонент для використання в стандартнiй компланарнiй схемi дифракцiї (дво-, та тривiсна конфiгурацiя), а також для дифракцiї в ковзнiй геометрiї (некомпланарна схема) дифракцiї i рефлектометрiї (для аналiзу тонких шарiв, форми квантових точок, величини латеральних напруг, хiмiчного складу) (Голландiя).
- X'Pert MRD Applications
X'Pert Epitaxy була розвинута для вирішення проблем матеріалознавства при використанні Х-променевої дифрактометрії. X'Pert Epitaxy використовується для аналізу даних, отриманих при використанні X'Pert PRO дифрактометра для визначення кристалічної якості осаджених шарів. Тонкі шари можуть бути від майже досконалих монокристалів (наприклад: III-V напівпровідникові лазерні структури) до текстурованих полікристалів (напр.: магнето-оксидні шари).
The functionality includes:
-calculating the mismatch, composition, thickness and relaxation of layers from rocking curves and maps
-analysis of regular arrays of rocking curves recorded from a wafer
-simulation and automatic fitting of rocking curves for semiconductors
The materials which can be analyzed using X'Pert Epitaxy include
III-V compound semiconductors: GaAs, AIGaAs, InP, InGaAs, InSb and so on
II-VI compound semiconductors: CdTe, HgCdTe, ZnSe, ZnTe
gallium nitride based device structures
silicon, silicon germanium alloys
epitaxial high Tc superconductors
epitaxial metallic layers and multilayers
highly oriented polycrystalline layers: PtSi on Si and so on
ferroelectric non-volatile RAM structures
X'Pert Epitaxy can extract information on structural parameters such as:
lattice mismatch between layer and substrate
alloy composition of layer
layer thickness
superlattice period
substrate curvature
mosaic spread
layer relaxation
For information about data collecting procedures see:
The Diffractometer Axes
The Reciprocal Space Interface
Scaling in Reciprocal Space
Single Scan Directions in Reciprocal Space
Area scans
Diffractometer Resolution
The Reciprocal Lattice of Real Samples
Recording a Rocking Curve - Двокристальний рентгенiвський дифрактометр ДРОН-3 з мiдним характеристичним випромiнюванням для використання в стандартнiй компланарнiй схемi дифракцiї для зйомки кривих гойдання в сполуках А3В5 (Росiя).
- Трикристальний рентгенiвський дифрактометр ТРС-001 з сумiщеними оптичними осями для використання в стандартнiй компланарнiй схемi дифракцiї (дво-, та тривiсна конфiгурацiя) для аналiзу тонких шарiв, величини латеральних напруг, хiмiчного складу) (Росiя).
- Двокристальний рентгенiвський дифрактометр ДРОН-3М з мiдним характеристичним випромiнюванням для використання в стандартнiй компланарнiй схемi дифракцiї для зйомки кривих гойдання в кристалах та сполуках кремнiй-германiй (Росiя).
- Порошковий рентгенiвський дифрактометр ДРОН-3М з мiдним характеристичним випромiнюванням для для зйомки дифрактограм вiд полiкристалiчних та аморфних сполук, фазового аналiзу (Росiя).
- Однокристальний рентгенiвський дифрактометр ДРОН-3М з мiдним характеристичним випромiнюванням для використання в стандартнiй компланарнiй схемi дифракцiї для зйомки енергетичних залежностей поблизу К-країв поглинання компонент в кристалах (Росiя).
Перелік послуг, які можуть бути надані ЦКК в області виконання вимірювань і аналізів:
- Визначення концентрації 2-х компонентних твердих розчинів і рівня залишкових пружних деформацій в епітаксійних шарах GexSi1-x; InxGa1-xAs; GaAs1-xPx; InAs1-xPx; GaAs1-xNx і інших.
- Визначення параметрів багатошарових епітаксійних структур методом Х-променевої дифрактометрії. Товщина шарів, склад, період повторення.
- Вимірювання товщини тонких шарів і шорсткості поверхні по кутових спектрах розсіяння жорсткого Х-випромінювання.
- Визначення параметрів багатошарових дзеркал з допомогою Х-променевої рефлектометрії. Товщина шарів, період повторення і дисперсія.
- Визначення відхилення зрізу пластини від кристалографічної площини.
- Аналіз епітаксійних шарів високотемпературних надпровідників.
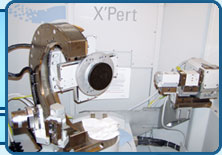


 укр
укр eng
eng